��Ч���ܼ���Ŵ��·���A֪�R
��Ч�����w��FET(Field Effect Transistor)���Q��Ч���ܣ�������늉��a����늈�Ч��������ݔ������Ĵ�С�ģ����;��w���O��һ�Ӿ��зŴ����á�
��Ч���ܲ��H����һ�㾧�w���O���w�eС�������p�������L�����c������߀��ݔ���迹�ߡ����͡��������졢���ڼ��ɵȃ��ݣ��ʱ��V�������ڼ����·�С�
������Y���IJ�ͬ����Ч����ͨ���֞�Y�͈�Ч����(JFET)�ͽ^���ň�Ч����(IGFET)�ɴ���������Ƚ�B�˃ɷN��Ч���ܵĽY��������ԭ�����������������������^��Ч�����c���w���O�ܵ����c���U��������Ҫ����������B�ˈ�Ч���ܵăɷN�����Ŵ��·——��Դ�Ŵ��·����©�Ŵ��·���҂���������ƫ���·��������Ч�·��������������ָ�˵�Ӌ����
3.1 �Y�͈�Ч����
3.1.1 �Y�͈�Ч���ܻ����Y�������
�Y�͈�Ч���ܿɷ֞�N�ϵ���P�ϵ��ɷN��͡������ĽY��ʾ��D���������·��̖Ҋ�D3.1���D3.1(a)��N�ϵ��Y�͈�Ч�ܵăȲ��Y�����·��̖������һ�KN���댧�w���σɂȣ�ͨ�^�ߝ�ȔUɢ����ɂ��ؓ��s��P+�ͅ^���γɃɂ�P+N�Y���уɂ�P+�^����һ���γ�һ��늘O���Q��ŘO��G�������g��N�ͅ^���d���ӵ���ͨ·�����Q֮�錧늜ϵ��������ăɶ˷քe�����ɂ�늘O���քe�Q��Դ�O��S����©�O��D���������@һ�������ⲿ��Ҳ�����l늘O�������ăȲ���Ҳ�DZ������ăɂ�PN�Y���������Č�늜ϵ���N�Ͱ댧�w����ȡ��N�ϵ��Y��FET���D3.1(b)��P�ϵ�JFET�ĽY�����·��̖�����cN�ϵ�JFET����ƣ�ֻ�nj�늜ϵ�׃��P �Ͱ댧�w���D�ЖŘOG�ļ��^�����ʾ��GS֮�gPN�Y����ƫ����

3.1.2 �Y�͈�Ч���ܵĻ�������ԭ��
��Ч����������늉��a����늈�Ч��������ݔ������Ĵ�С�ģ��䌍�|����ͨ�^��׃���ږ�Դ֮�g�ķ�ƫ늉�UGS����׃PN�Y�ıM�ӵČ��ȣ��Ķ���׃�ˌ�늜ϵ��Č��ȣ�Ҳ���Ǹ�׃�ˌ�늜ϵ�����裬��K���F��ݔ�����ID�Ŀ��ơ�
N�ϵ�JFET�����������r����Դ֮�g����늉� UGS��0������Դ֮�g��PN�Y̎�ڷ�ƫ��B�������Է���������t�ŘO������㡣�@�r©Դ֮�g���ID�Ĵ�С�ɜϵ��ʬF������С�Q�������ϵ����Ĵ�С�t�ɜϵ��İ댧�w���ϵ���輰�ߴ�Q�������ږ�Դ֮�g��P+N�ӵ��Ƿ�ƫ늉�����P+N�Y�Ŀ��g늺Ʌ^���Ȍ��S��ƫ늉�����������ҿ��g늺� �^��Ҫ��ϵ�һ�����죬�@�ӣ���׃UGS�Ĵ�С�r���_���˿��Ɯϵ����ȵ�Ŀ�ģ��Ķ����F�ˌ��ϵ����Ŀ������á���©Դ֮�g����UDS��0��늉��r��©Դ���ID�͌��SUGS��׃����׃�����M���_��UGS��ID�Ŀ���Ŀ�ġ�
�ڈD3.2��ʾ����r�£��҂����Կ�����UDS��0�r��UGS׃�����䌧늜ϵ���Ӱ푡�����ʾ��UGS���ϵ����ȵĿ������á��ɈD��Ҋ����UGS��0�r����늜ϵ�������˕r�ӵ�©Դ늉�UDS���t������ID���|UGS|Խ���䌧늜ϵ���Խխ�������Ĝϵ�����Խ�������©Դ֮�g����늉�UDS�r����©�O�����ԽС����|UGS|���ӵ�һ����ֵ��||��늉��r������P+N�Y�ĺıM�^��ϵ�һ�ȔUչ�ĽY����ʹ�ϵ���ȫ��ʧ�����ɂ�P+N�Y�ĺıM�^��ȫ�ϔn������D3.2(c)��ʾ���@�N��Bͨ�Q��ϵ��ĊA���B�������ķQ��A��늉����˕rJFET��©Դ֮�g��ʹ����늉�UDS��Ҳ�����Мϵ�����a������ID��0��

�ɴ��҂�����֪�������ږ�Դ֮�g�ӵķ�ƫ늉����ʏĖ�
�O���Mȥ���ʬF���迹�ܸߣ����⣬����UGS�a����늈�Ч
��ͨ�^��P+N�Y�ıM�^���ȵĿ��ƿ�����Ч�،��F��©�O�
���Ŀ������ã��Ү�UGS��UP�r�����ڜϵ��A�࣬©Դ֮
�g̎�ڔ�·��B��
2.��DS��ID��Ӱ�
��UGS��0�r����׃UDS����늜ϵ��a����Ӱ푣���D3.3��ʾ����N�ϵ�JFET���������r��UDS��0����©Դ֮�g�����O��늉�����UGS��UDS��0�r������©���cԴ�˵Ĝϵ�����һ�ӣ������о���Ĝϵ����ȣ���D3.2(a)��ʾ����UGS��0��UDS��0�r���t����©�˵�P+N�Y��ƫ늉�Ҫ���ڿ���Դ��P+N�Y�ķ�ƫ늉�����˺ıM�^��ϵ�һ������Č��ȾͲ�ͬ�ˣ����¿���©�˵Ĝϵ�����խ������Դ�˵Ĝϵ����Ȍ����@�N�Ӝϵ��L�ȷ����Ϝϵ����ȵIJ�����������UDS����ġ�����w������£����UDS��0��©Դ֮�g�a����һ���^����������ID�ķ����Ǐ��ϵ��£������ϵ��ķ������������һ��늉����䡣�OԴ�O�������棩�λ�酢���c���t�ϵ��ϸ��c���λ��ͬ��������D�c���λ��ߣ�������Դ�O̎�λ��͡�PN�Y�ķ���ƫ����ֵ�������濿��©�OD�c������ԺıM�^�����������Դ�OS̎����С�����ԺıM�^��խ������γɵĺıM�^���Π����ό���խ���S��UDS�����@�N�ϵ����Ȳ������Ԍ�Խ�l���@��
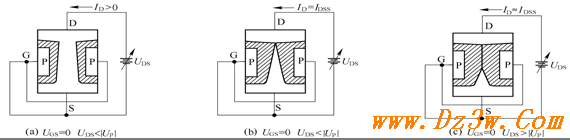
һ����UDS�����r���t����©�˾ͳ��F�˜ϵ��ϔn����r����D3.3(b)��ʾ���@�N��Bͨ���Q���A�A���B���A�A���cǰ��ĊA���Dz�һ�ӵģ��������A�A���r��©Դ֮�g���^���������^�����A���B�r���tID��0�����������_�A�A���B�����^�m�Ӵ�UDS���t�������F�ıM�^�ĺϔn�c���A�A���c���ϵ���Դ�O�����ƄӵĬF����3.3(c)��ʾ���@������늜ϵ�׃�̣��Ķ�ʹ�ϵ�������МpС����׃�������@�����ڊA���^�Ǹ���^�����늉�UDS��������Ҫ�������A�A���^��������ϵ��L�ȵ�Ӱ���С���@�N�SUDS׃���ϵ��L���S֮����׃���ĬF��Q��ϵ��L���{��Ч������Ҋ���ڜϵ��A�A��֮��UDS׃�����ϵ����ID��Ӱ��Ǻ�С�ġ���Ч���ܵ��@�N������B�Q������^��ͅ^��Ŵ�^��������Ŵ�Ԫ��������Ч���ܾ��ǹ������@һ��B�����^����ע�⣬��UDS�^��r������P+N�Y�ķ�ƫ�^���a����������F�����r��횱����@�N��r�l����
3.1.3�Y�͈�Ч���ܵ��������������W����
ݔ������


(4) �����^
�����^��D3.4(b)�����҂ȵIJ��֣���ʾ�����ߵ�һ���̶Ⱥ���ƫ�õ�PN�Y������������������������^���ӌ����p�ġ�һ����U(BR)DS����ʾ����©Դ֮�g�ē���늉���ʹ�������r����횱��CU DS��U(BR)DS���Է�ֹ�����M������^��һ��U(BR)DS��20��50V֮�g�����SUGS�����Ӷ����ӣ��@��ʹ�Õr������ע�⡣
����P�ϵ�JFET��ԭ�������ԣ����cN�ϵ�JFET����Ҫ��e������UGS��UDS�����늉��O�ԣ���P�ϵ�JFET�У�UGS��0����UDS��0��������ԭ���c����ͬ�W���������з�����
3.2 �^���ň�Ч����
3.2.1 �^���ň�Ч���ܻ����Y�������
�^���ň�Ч����Ҳ����N�ϵ��cP �ϵ��ɷN��͡�N�ϵ�IGFET�Ļ����Y����D3.5��ʾ������һ�K�s�|����^�͵�P�ͱ���Ƭ���r�ף�����픲��γɃɂ��ߓ��s��N+�^���քe����������Դ�^��©�^����������
�����ɂ�늘O��Դ�OS��©�OD����Դ�^�c©�^֮�g��P���r��ƽ������������ˇ���Lһ�ӘO���Ķ�������^���ӣ���ԓ�^�����ϳ��e�������X�Ӳ�����늘O����ŘOG���r������һ���Wķ���|늘O���Q���r��늘O���÷�̖B��ʾ���@�N�����ĖŘO�c�r�ױ���Ľ^������SiO2���ʰ����Q�����–������–�댧�w��Ч���ܡ���MOSFET��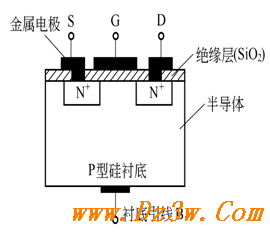
�����ږ�Դ늉�UGS��0�r��©Դ֮�g�Ƿ���ڌ�늜ϵ�����r��MOSFET�ֿɷ֞������ͺͺıM�̓ɷN��ͣ��քe��EMOSFET��DMOSFET��ʾ����UGS��0�r��D��S֮�g�o��늜ϵ����ڣ��ͷQ����������������UGS��0�r��D��S֮�g�Ќ�늜ϵ����ڣ��ͷQ��ıM���������@�ӣ�MOSFET����4�N�ϵ�������MOSFET��N�ϵ��ıM��MOSFET��P�ϵ�������MOSFET��P�ϵ��ıM��MOSFET�������ķ�̖�քe�ɈD3.6��ʾ��
3.2.2 N�ϵ�������MOSFET
ǰ���҂��ѽ�ӑՓ��N�ϵ�IGFET�Ļ����Y������D3.5��ʾ�����������MOSFET�r���ڶ�������^�����в������x�ӣ��t����N�ϵ�������MOSFET��������������x�ӣ��t��N�ϵ��ıM��MOSFET�������҂���ӑՓN�ϵ�������MOSFET�Ĺ���ԭ�������������ԡ�
1.N�ϵ�������MOSFET�Ĺ���ԭ��
�����������ں����^Ҳ�����ڷŴ��B�r���乤��ԭ���cJFET���M��ͬ���˕rN�ϵ�������MOSFET���r��늘OB��횽����·�е�����λ�ϻ��cԴ�O��ӡ���UDS��0���@��ʹDS�ăɂ�N+�^�c�r��֮�gʼ�K̎�ڷ�ƫ��B��UGS��횼����O�Ե�늉����Ա��C�γ�©Դ֮�g�Č�늜ϵ���������wӑՓ��
(1) UGS��ID�Ŀ���
��UGS��0�r��N+Դ�^�c©�^֮�g��P���r�������_���ͺ���ɂ���������PN�Y����©Դ�o������^���@�r�����J�����̎�ڊA���B����UGS��0�r���ږŘO�c�r��֮�g�γ����ɖŘOָ���r��늈����˕r�ŘO�c�r��֮�g�O����SiO2�^���Ӫq��һ��ƽ��������Ľ��|����늈��������£�P���r���в�����������ӱ��������r�ױ���̎�������ӿ�Ѩ���ų��x�_�r�ױ��档�S��UGS�����ӣ��ŘO��ֱ���r�ױ����늈�Ҳ���������������r�ױ�����������ҲԽ�ࡣһ����UGS���ӵ�ijһ늉�UT�r���r�ױ����������Ӕ����ʹ��ڿ�Ѩ�������������r�ı����γ����cP�Ͳ����෴��N�ͅ^������Դ�^��©�^��B���������γ���Դ©�^֮�g�Č��ͨ·���@һN�͌�ͨ���Q֮�鷴�͌ӣ��������_ʼ�γɷ��͌�����Ė�Դ늉�UT�Q���_��늉������Сһ����2��10V֮�g������˕r�^�m�Ӵ�UGS���t�����ķ��͌Ӻ�Ⱦ��S֮�Ӵ������Ҳ��Խ�����f��N�ϵ�������MOSFET�ϵ��γɵ�ʾ��D��D3.7��ʾ��UGS���ϵ��Ŀ��ƽY��Ҳ���_���ˌ�ID���Ƶ�Ŀ�ģ�����w��r�����D�����ԁ���ʾ����Id=f(Ugs)|Ugs=����.
2.N�ϵ�������MOSFET�������������䔵�W����
N�ϵ�������MOSFET���D�����������cݔ������������D��ʾ��
3.2.3 ������͵�MOSFET
��N�ϵ�����MOSFET�⣬߀��N�ϵ��ıM��MOSET��P�ϵ������ͺͺıM�����N
3.2.4 VMOS���ʈ�Ч���ܺ���
ͨ�����MOS�ܹ����������k���ǣ����ÿv��ֱ����늜ϵ��ʹ�Ҏģ�����·���g�����S��С����MOS�ܵĹ�о������U���·���pС��ͨ��裬���ɹ���MOS�ܡ�
��N�ϵ�MOS��(NMOS)��������B�@�N���пv��Y����V��MOS��(VMOSFET)�ĽY�����c���D3.9����Y������D������N+��������r�ף��γ�©�OD�������ڴ˻��A����
���������͓��s��N�����ӌӡ�P�ͅ^
����늜ϵ����ߓ��s��N+�^���γ�Դ
�OS�������^N+�^��P�^�����g��һ��V
�Ͳۣ����ڱ������Lһ��SiO2,�ٸ��wһ
�ӽ�������ŘOG�� 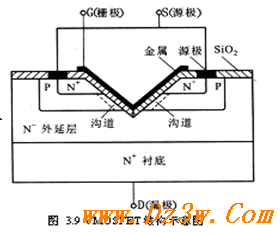
���ŘO����늉��r��������Ĥ�µ�P�͌Ӄ�߅�������γɌ�늜ϵ�����©Դ֮�g����늉�(UGS��0)���t��ӏ�Դ�Oͨ�^�ɂ��ϵ����_��N�����ӌӣ���ͨ�^N+�r������©�O,��Ҋ����،�늜ϵ����\���ǿv��ġ�
���ڹ���MOS�ܵ�©�^��e��������ɢ�ᣬ��P���cN�����ӌ��γ�һ��ƫ��PN�Y�����ĺıM�Ӵ��λ�ړ��s���p�����ӌ��У����©�O�cԴ�O֮�g�ķ������늉��^�ߣ������������ɴ���������Ŀǰ���еĹ���MOS���͉����_1000V���ϣ�����B�m���200A��
V��MOS�����_�P�ٶȸߡ������С���^�d�����������ڲ������c����MOS���c�p�O�����w����ȣ�����l�p�Ĵ��������o��Ɖģ����ԑ��Õr��ӱ��o�·��
3.3 ��Ч���ܵ����c����Ҫ����
3.3.1 ��Ч�����c���w���O�ܵı��^
��Ч�����c�p�O�;��w������^����������һЩ���c��
(1) BJTݔ��˵�PN�Y������ƫ�ã��������ݔ������^��������ݔ����蔵С����JFETݔ��˵�PN�Y�鷴��ƫ�ã���IGMOSFET�t�н^���Ӹ��x����������ݔ�����ܴ�ͨ��JFET��ݔ�����10^8����IGFET��ݔ�����ɴ���10^11��10^12��
(2) FET�ǿ����ӌ�늵�����������Ҳ�Q��ΘO����������BJT�У�������Ӽ���Ѩ�����c�����������ַQ���p�O�����������ڶ��ӝ���ܜضȡ����ա�ݗ��ȭh��׃����Ӱ�С������FET�e�m���ڭh���l��׃���^�������O���С�
(3) �ڵ͉�С��������r��FET������늉����ƵĿ�׃�������͌�ͨ����С�ğo�|�c�_�P����BJT�t�o�˃������ԡ�
(4) FET��һ�N�Ը��x���������칤�����Σ��e�m���ڴ�Ҏģ�c����Ҏģ�����·���OӋ�c���졣�Į�ǰ�İlչڅ�ݿ������@Щ���ɶȺܸߵĴ�Ҏģ�c����Ҏģ�����·�У�MOSFET������ȡ����BJT��
(5) �������ĽY������FET��©�O�cԴ�O�nj��Q�ģ����Ի��Qʹ�ã��OӋ�rҲ�^BJT�`�
�e��Ҫָ�������ڱ����ʹ��MOSFET�rҪ�������ģ�������ĖŘO�c�r�ױ���֮�g�Ľ^���Ӻܱ���������w�����w���|���ٖŕr�����ڕ��ږŘO�c�r���Ϯa������늺ɣ����ŘO�c�r��֮�g��ƽ������������ֺ�С�����Գ����@Щ����늺ɷe�ە��ڽ^�����Ϯa���ܸߵ�늉����O���½^���ӵē������p�Ĺ��ӡ������@�N�����ڱ���r������늘O�����̽ӣ����ӑ�������F�⚤���ýӵأ���Ҫ�r߀���ڹ��ӵĖ�Դ֮�g���뱳�����ă�ֻ�����ܣ������Ƹ���늺��ږ�Դ֮�g�a�������늉���������Ӗ�Դ֮�g��������p�ġ�
3.3.2 ��Ч���ܵ���Ҫ����
1.ֱ������


3.4 ��Ч���ܻ����Ŵ��·
��Ч���ܵ�����늘O�c���w���O�ܵ�����늘O�����������Pϵ�����ŘO�c���OB��Դ�OS�c�l��OE��©�OD�c��늘OC�քe������ͬ�ӣ��Ɉ�Ч���ܽM�ɵķŴ��·Ҳ���й�Դ�����š���©���N�M�B����Ŵ���Ӌ�㣬Ҳ���ý���С��̖��Ч�·����������
3.4.1 ��Ч���ܵ�ƫ���·
��Ч���ܷŴ��·Ҳ����ƫ���·����һ�����m���o�B�����c������ͬ���ǣ���Ч������늉�����Ԫ������ֻ��Ҫ���m��ƫ����������Ҫݔ����������⣬��ͬ��͵Ĉ�Ч���܌�ƫ��늉��ĘO���в�ͬҪ���ڌ��H�·�У���Ҫ�M��늉��O��Ҫ����Ҫ�M���M����Դ��늣���ˈ�Ч���ܷŴ��·һ�㶼�����Խoƫ���ķ�����
1.ֱ��ƫ���·
(1) ��ƫ���·
�D3.10(a)����N�ϵ��Y�͈�Ч���ܘ��ɷŴ��·����ƫ���·��RG�Q��ŘO��裬Ҳ�Q��ŘO©��裬���Q��©��裬���Á�ጷŖŘO�Б�늺ɣ���ֹ�ŘO���Б�늉�������ͬ�rҲ���ƫ���ṩ��ֱ��ͨ·��ͨ��RGȡֵ�ܴ������ݔ�����
��Ҋ��ԓ�·ʹ��0����0���ṩ��һ�����m���o�B�����c��ʹ��Ч�����܉��������ķŴ����á��@�N�·�Ė�ƫ���ǿ���Ч���ܵ�����©����a���ģ��ʷQ����ƫ���·��
(2) �։�ʽ��ƫ���·(���ƫ��)
������ƫ���·�mȻ�Y�����Σ���RS�����^��t�o�B�����c���½���Ӱ푄ӑB�����������pС�Ŵ�����˵��{�������^С������ԓ�·ֻ���ṩؓ�Ė�ƫ�����m���ںıM�͈�Ч���ܣ������m���������͈�Ч���ܣ��������ƫ���·�Ͻo�ŘO�ټ�һ���ķ։����t��ƫ����׃�������Ϳ���������D3.10(b)��ʾ�Ƿ։�ʽ��ƫ���·����������ƫ���·���A�Ͻ���։���蘋�ɵģ����c���ܷ����o�B�����c�����m���ڸ��Ч���ܵķŴ��·��
2.�o�B����
3.4.2 ��Ч���ܵ�׃��Ч�·
3.4.3 ��Ч���ܵĻ����Ŵ��·���ܷ���
��Ч����Ҳ���й�Դ����©���ŘO���N�M�B�ķŴ��·����ӑB�����c���O�ܵĄӑB����������ͬ���䲽�EҲ���ҳ��佻��ͨ·����׃��Ч��Q��Ȼ���·��������Ӌ�㡣
1.��Դ�·
��Դ�Ŵ��·��D3.13(a)��ʾ���D(b)���佻����Ч�·��


����R0�Ķ��x���ɮ�����ݔ�����R0�ĵ�Ч�·����D(c)��ʾ��
3. ���N�M�B�Ŵ��·�ı��^
���������Ĺ�Դ����©�Ŵ����⣬߀��һ�N���ŷŴ������ڴ��҂������M�з����ˣ��@���҂��ш�Ч�������N�M�B�Ŵ��·�����ܱ��^�ñ�3.2������������
- ��һƪ�� ���D������������ӹ��Ļ��A֪�R
![IC�]ُ�W���Ԫ��Ʒ�|����](/static/img/950.jpg)